在大氣環(huán)境中,軟錯誤主要來源于阿爾法粒子,、高能中子和熱中子,。我所輻照團(tuán)隊最新的研究成果表明,65 nm工藝SRAM在北京地面應(yīng)用時的總體軟錯誤率為429 FIT/Mb,,其中阿爾法粒子的貢獻(xiàn)為71%(詳見文后鏈接),。在航空應(yīng)用環(huán)境中,若不對電子材料進(jìn)行阿爾法粒子發(fā)射率控制,,其引起的軟錯誤率將同樣高于大氣中子,,成為致命威脅。因此,,針對高可靠,、大規(guī)模電子系統(tǒng)進(jìn)行阿爾法軟錯誤測試和評價,對提升產(chǎn)品可靠性具有重要意義,。

圖 1 阿爾法衰變示意圖
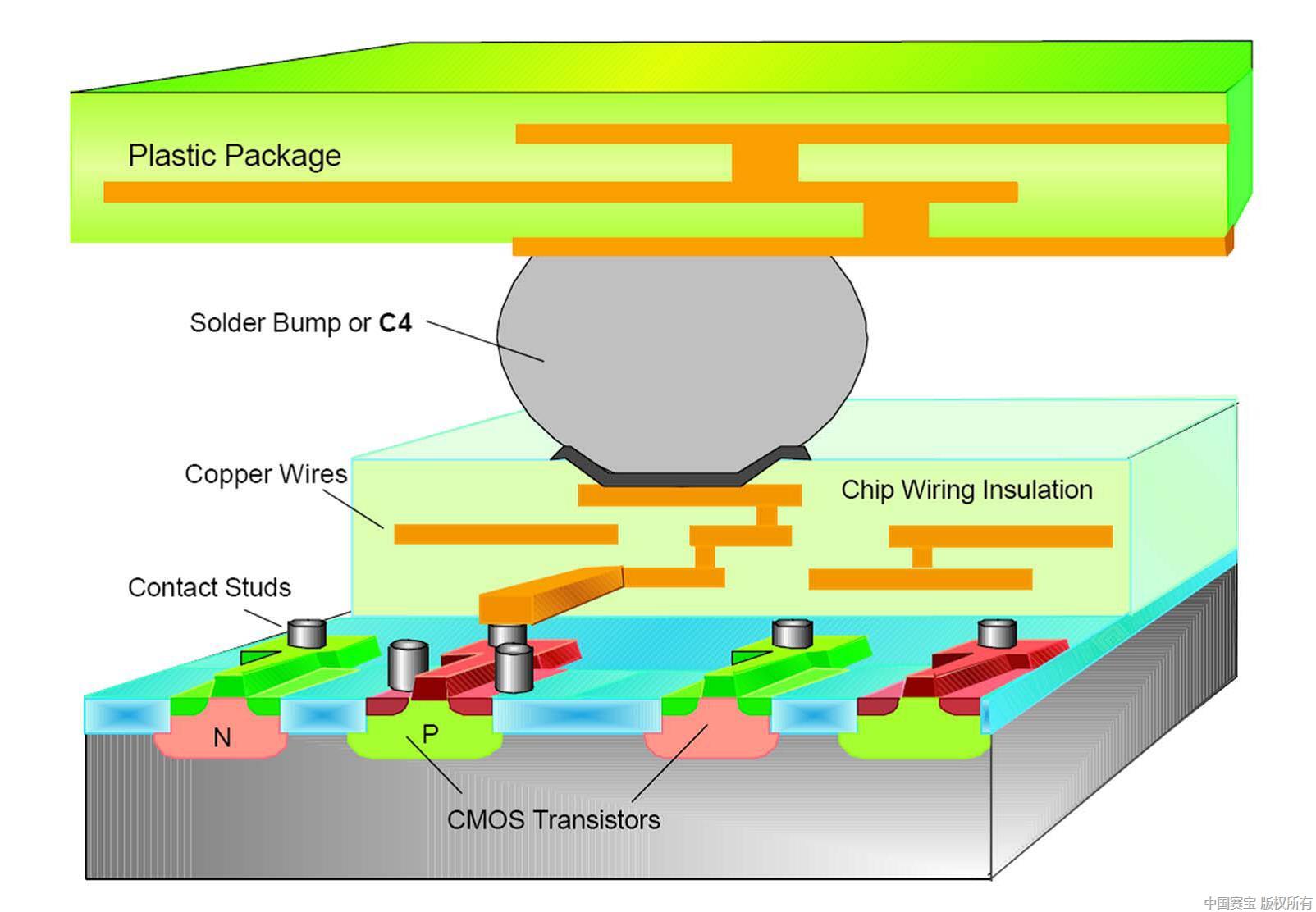
圖 2 半導(dǎo)體器件封裝中的阿爾法粒子來源(圖片來源:IBM)
Copyright © 2015. 中國賽寶實驗室 All rights reserved. 廣州市增城區(qū)朱村街朱村大道西78號
業(yè)務(wù)聯(lián)系:020-87236881
 粵公網(wǎng)安備 44011802000613號
粵ICP備17163142號-12
粵公網(wǎng)安備 44011802000613號
粵ICP備17163142號-12